반응형


[질문 1]. Photo Lithography 공정에 대해서 설명하세요.
- Keyword : [반도체 회로, 규격화된 빛, 이미지 패턴, 전사, 미세화, Photoresist, 후속공정의 barrier]
포토 공정은 설계한 반도체 회로 정보를 포함한 마스크에 규격화된 빛을 이용하여 웨이퍼 위에 이미지 패턴을 전사시키는 공정입니다. 웨이퍼에 감광물질인 Photoresist (PR)을 도포한 후, 마스크 패턴을 정렬하고 UV 등의 빛을 노광시켜 회로 패턴을 얻습니다. 형성된 감광막 패턴은 후속공정인 식각 혹은 이온 주입 시 Barrier 역할을 수행합니다.

[질문 2]. 포토공정의 Process에 대해서 설명해주세요.
- Keyword : [Wafer 로딩, HMDS, 스핀코팅, Alignment, 노광, PR, Soft-, Post-exposure-, Hard bake, Develop]
포토공정의 프로세스에 대해서 답변드리겠습니다. 웨이퍼 로딩 후, Photoresist와 웨이퍼의 접착도를 향상시키기 위해 HMDS 혹은 BARC 박막을 형성해줍니다. 이후 PR을 도포한 후 휘발성 물질을 제거해주기 위해 Soft bake를 실시해줍니다. 이후 Scanner 혹은 Stepper 설비에서 마스크를 정렬하고 노광공정이 수행됩니다. 이후 Post-exposure bake (PEB) 열처리 이후 현상액을 이용하여 감광된 PR패턴을 제거해줍니다. 후속공정을 위해 이미지 패턴이 견고해질 수 있게 Hard bake를 진행 후, Develop Inspect를 통해 원하는 회로패턴이 잘 형성됐는지 확인해줍니다.
[세부 설명] : Photoresist는 스핀코팅으로 도포되기 때문에 액상형태로 90%의 Solvent에 용해되어 있습니다. 후속공정인 에치공정에서 Solvent가 차지하는 비중이 많으면 유기박막의 물성 자체가 약해지기 때문에 이를 단단하게 해주기 위해 공정 중간 중간에 Soft-, Hard bake 공정이 진행되는 것입니다.
[꼬리 2-1]. HMDS가 무엇인데요.
HMDS는 웨이퍼 표면을 소수성으로 바꿔주어 PR 도포시 PR의 접착력을 증가시켜주는 역할을 합니다.
[꼬리 2-2]. PEB (Post-Exposure Bake)의 필요성에 대해서 설명해보세요.
[개념] : PEB는 노광 이후 파장을 가지는 빛의 성질에 의해 Standing wave effect 가 발생합니다. 이로 인해, develop 과정에서 PR 박막의 vertical profile에서 side 부분이 우는 현상이 발생하게 됩니다.
[해결] : 이를 방지하기 위해서 Post-Exposure Bake를 통해 PR 내부에 PAC (Photo Active Compound)를 활성화 시켜줌으로써 빛을 받은 부분과 받지 않은 부분의 Selectivity를 높여줄 수 있습니다.
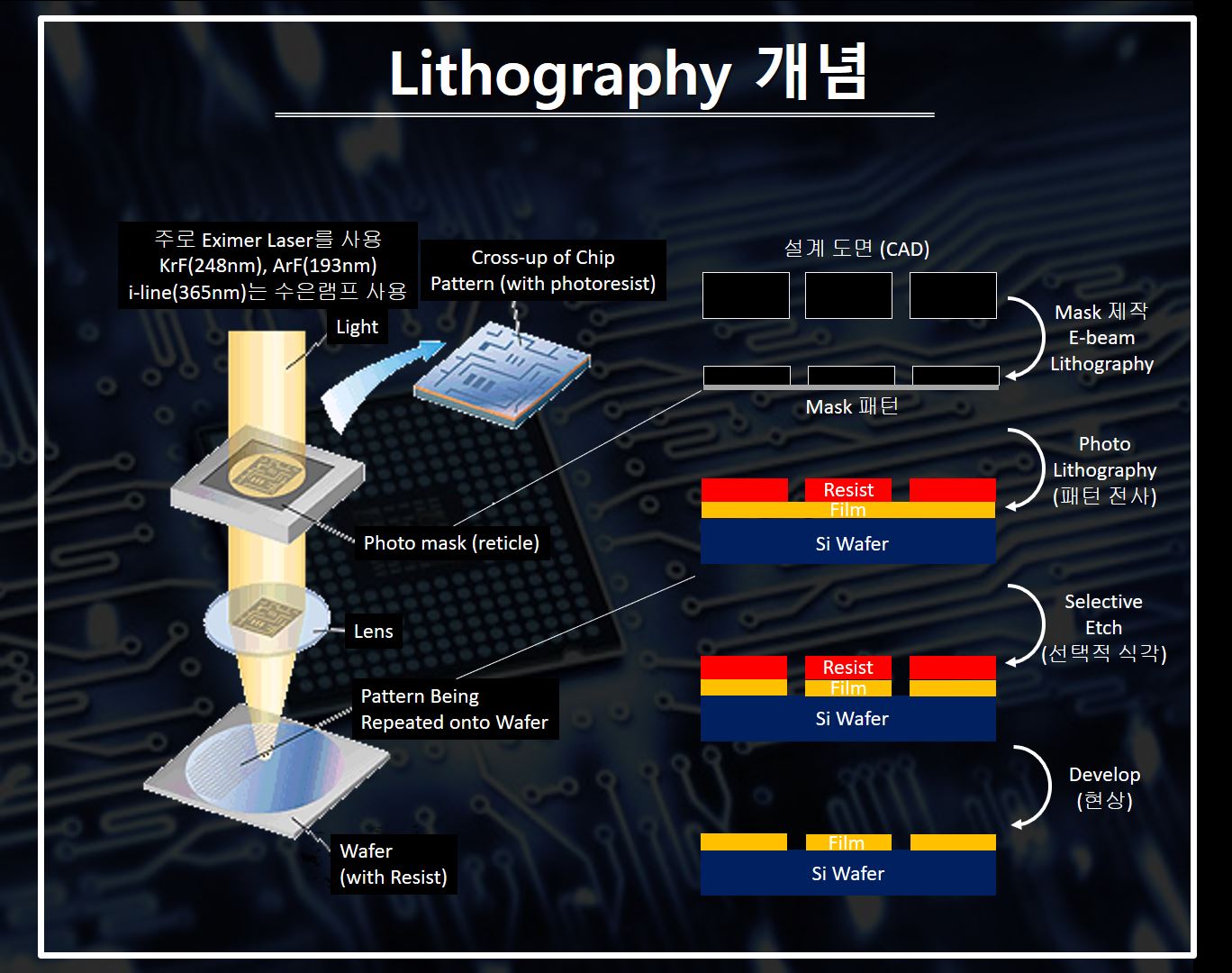
[질문 3]. Photoresist (PR)에 대해서 설명해주세요.
- Keyword : [Photoresist, Resin, PAC, PAG, 산염기 반응, PEB, TMAH 현상액]
Photoresist는 빛을 센싱할 수 있는 물질입니다. PR의 주성분은 Resin으로 가장 많은 비중을 차지합니다. 그리고 빛을 센싱할 수 있는 물질인 PAC(Photo Active Compound) or PAG(Photo Acid Generator) 첨가제가 있습니다. 그리고 스핀코팅을 통해 유기박막이 잘 도포될 수 있도록 90%의 Solvent에 잘 용해시켜 액상형태로 유지합니다. 끝으로 resist의 코팅력을 향상시키거나 acid diffusion을 도와주는 계면활성제의 첨가제가 소량 첨가됩니다.
[꼬리 3-1]. Photoresist의 역할이 무엇인데요.
Photoresist는 앞서 말씀드렸듯이 빛을 센싱할 수 있는 기능을 가지는 물질입니다. 노광공정을 통해 이미지 패턴을 구현할 수 있으며, 후공정에서 에치공정이나 이온주입 공정에서 Organic Barrier 마스크 역할을 합니다.
[꼬리 3-2]. Develope 과정의 메커니즘에 대해서 설명해보세요.
PR이 제거되는 원리는 산염기 반응입니다. 빛이 입사해서 PR에 도달하게 되면 빛을 받은 부분은 acid가 발생하게 됩니다. 그리고 Post-Exposure Baking을 통해 산이 확산되어 활성화됩니다. 그 결과 빛을 받은 부분과 받지 않은 부분의 경계가 구분됩니다. 이후 TMAH 약알카리성 현상액으로 산염기 반응을 통해 Salt 가 형성되고 빛을 받은 부분이 제거됩니다.
[꼬리 3-3]. Positive-type & Negative type PR의 차이에 대해서 설명해보세요.
Positive-type PR은 빛을 받은 부분이 제거되고, Negative-type PR은 빛을 받지 않은 부분이 제거됩니다. 일반적으로 Positive-type PR이 주로 사용되어 양산되고 있습니다. Positive type은 Negative type에 비해 Resolution 이 우수하고 현상 시 잔류감광막인 Scum 형성이 적습니다. 또한 Step coverage, 열적 안정성도 우수한 장점이 있습니다. 이러한 이유로 미세화 트랜드에 따라 Positive PR이 채택되고 있습니다. 하지만 PR의 비용이 상대적으로 높다는 단점이 있습니다. Negative type PR은 산화막에 대한 접착도가 우수한 장점이 있지만, Scum 형성도 심하며, 현상과정에서 PR이 swelling 되는 단점이 있습니다.
| Positive type Photoresist | Negative type Photoresist |
| 광원에 노출된 부분이 화학적인 '분해'로 인해 현상액에 의해 제거됨. (Decomposition) |
광원에 노출된 부분이 화학적으로 '결합'하여 노출되지 않은 부분이 현상액에 의해 제거됨 (Cross linking) |
빛을 받아 제거되는 부분의 상단부 주위도 화학결합이 약해지면서 현상 후 아래와 같은 profile을 형성함.  |
빛을 받은 부분의 상단부 주위의 화학결합이 강해져서 현상 후 아래와 같은 profile을 형성함 |
| Positive PR은 해상도가 높아 패턴이 선명하게 진행되고, PR 잔여물인 Scum 형성이 없고, step coverage, 열적안정성이 Negative PR에 비해 우수함. 현상 후에 removing이 잘 되는 장점 | Positive PR에 비해 패턴 선명도가 떨어짐. 산소와 잘 결합하여 하부층을 이루는 산화막과 접착도 특성이 우수함 |
| 산화막과 접착도 특성이 불량함. 빛에 민감하고 Uniformity가 우수하지 않음. | 현상 시 Swelling 현상 발생. devlope에 들어가면서 원하지 않는 부분과 화학반응을 일으켜 부풀어 오르는 문제가 발생하여 해상도가 저하됨. 또한 Negative profile로 인한 패턴의 쓰러짐이 발생함. |
반응형
그리드형(광고전용)
'반도체사관학교 훈련과정 > 반도체 전공정' 카테고리의 다른 글
| [포토공정] 훈련 6 : "포토공정, 공정여유 or 공정마진" (24) | 2022.01.08 |
|---|---|
| [포토공정] 훈련 5 : "Resolution과 DoF의 관계에 대해서 설명하세요" (13) | 2022.01.08 |
| [포토공정] 훈련 4 : "Resolution에 대해서 공식으로 설명해보세요" (16) | 2022.01.07 |
| [포토공정] 훈련 3 : "Illumination mode, OPC, PSM 기술" (6) | 2022.01.07 |
| [포토공정] 훈련 2 : "포토마스크에 대해서 설명하세요" (8) | 2022.01.06 |








최근댓글